1nm工艺下金属互联新方法!互联发热问题得到解决
文章来源:好站长外链
作者:互联网
人气:11
 2021-07-12
2021-07-12
芯东西7月12日消息,比利时微电子研究中心(IMEC)开发了采用1nm工艺技术构建硅芯片过程中使金属互连的新方法,解决了1nm互连发热问题。
IMEC在上周的2021年国际互连技术会议(IITC 2021)上展示了这项实验研究。
一、IMEC发现电阻率更低的新材料
IMEC展示了基于铝的二元化合物的实验研究,重点是它们的电阻率,理想配比状态的AlCu和Al2Cu薄膜,电阻率低至9.5μΩcm。
这些结果在实验上支持了将AlCu和Al2Cu在先进的半镶嵌互连集成方案中用作新导体的可能性,在这些方案中它们可以与气隙结合以提高性能。然而,在这种组合中,焦耳热效应变得越来越重要。
将逻辑技术线路图缩小到1nm及以下需要在后端最关键的层中引入新的导体材料。铝和钌(Ru)的电阻率低于铜、钴或钼等传统元素金属,这可能会对1nm工艺下的芯片性能有所影响。
IMEC研究了包括AlNi、Al3Sc、AlCu和Al2Cu在内的铝化物薄膜的电阻率,在20nm及以上厚度时,所有PVD沉积薄膜都显示出与钼相当或低于钼的电阻率。28nm的AlCu和Al2Cu薄膜实现了9.5μΩcm的最低电阻率——该值低于Cu的值。实验还表明控制薄膜理想状态防止表面氧化是研究铝化物需要面临的挑战。
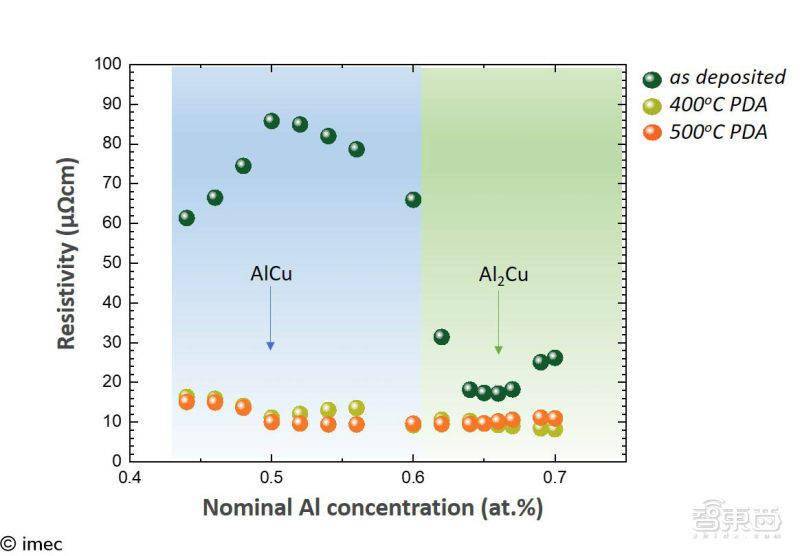
▲28nm厚的AlCu薄膜的电阻率与Al浓度的关系
二、更高的金属密度将减少焦耳热
IMEC设想在先进的半镶嵌工艺技术中使用这些金属间化合物,这需要直接对金属进行蚀刻,以获得具有更高纵横比的线条。IMEC发现通过在金属线之间逐渐引入部分或全部气隙,可以进一步改善RC延迟,用电隔离气隙代替传统的低k电介质,有望降低按比例缩放的电容。但是气隙的导热性极差,这需要对操作条件下的焦耳热效应格外注意。
IMEC通过在局部2层金属互连层上进行焦耳热“校准”测量,并通过建模将结果投射到12层后端连线(BEOL)结构上,从而量化了这个难题。该研究预测,气隙会使温度升高 20%。研究也发现金属线的密度起着重要作用,较高的金属密度显示有助于减少焦耳热。
IMEC研究员兼纳米互连项目总监Zsolt Tokei说:“这些发现是改进半镶嵌金属化方案使之成为1nm及以下互连选项的关键。IMEC正在通过其他选项扩展互连路线图,包括混合金属化和新的中间线方案,同时解决与工艺集成和可靠性相关的关键挑战。”
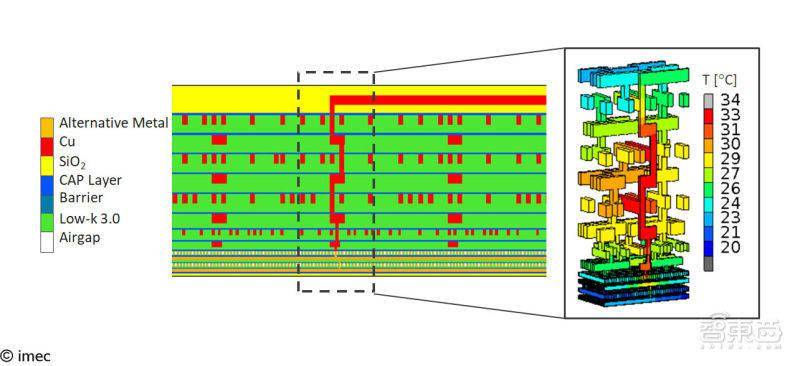
▲具有局部气隙的12层金属层互连温度图
结语:又一难题得到解决,1nm芯片距我们还有多远?
3nm芯片量产之日离我们越来越近,上个月底,三星宣布3nm芯片已经正式流片,各芯片制造头部玩家也正在加速推进将2nm技术投入使用的计划。
如今芯片制程的发展越来越接近物理极限,科学家和工程师们日益攻克包括互连发热问题在内的诸多技术挑战,ASML、三星、台积电、IBM等不同细分领域的芯片巨头都在试图从制造工艺、制造材料、封装方法等方面推动芯片走向1nm以及更小的制程节点。












